低温共烧陶瓷(Low Temperature Co-fired Ceramic,LTCC)是新一代高性能陶瓷集 成封装与电路基板核心技术,以陶瓷为基础材料,融合精密印刷、叠压共烧、微纳加工等工艺,可实现无源元件内埋、三维高密度电路集成,兼具小型化、高可靠性、高频低损耗、抗极端环境等优势,是5G/6G通信、微波毫米波、航空航天、汽车电子、高端工控等领域的核心基础工艺,更是实现电子器件高密度、微型化、集成化的关键解决方案。
依托全自主研发的材料体系与成熟的全流程生产线,我司已实现LTCC技术的产业化落地,完成生瓷片、浆料等核心原材料的国产化替代,可提供从定制化设计、工艺开发到规模化生产的一体化服务,产品覆盖民用通信、军用电子等多场景,兼具高性能与高性价比
LTCC技术以无机陶瓷粉为基材,搭配有机黏结剂制成浆料,经流延成型制备超薄生瓷带;通过激光/机械打孔、微孔注浆实现层间导通,利用高精度丝网印刷完成电路图形与内埋无源元件制作;根据产品需求将多层生瓷带叠压成型,最终在850-900℃低温环境下共烧一体化,形成三维空间互不干扰的高密度陶瓷电路组件。
成品可在表面贴装IC、芯片等有源器件,实现无源/有源一体化集成,大幅缩减器件体积,提升电路集成度与稳定性。
性能指标 | K5.9(自研) | K7(自研) | K7.8(自研) | 单位/规格 |
介电常数 | 5.9 | 7.4 | 7.8 | - |
介电损耗 | 0.0015 | 0.006 | 0.004 | - |
绝缘电阻 | >10¹⁰ | >10¹² | >10¹² | Ω |
击穿电压 | >1000/25 | >1000/25 | >1000/25 | V/um |
收缩率(X,Y方向) | 16±0.5 | 14.5±0.5 | 14±0.5 | % |
收缩率(Z方向) | 21±1 | 24.5±1 | 22±1 | % |
密度 | 2.45 | 3.1 | 3.2 | g/cm³ |
抗折强度 | 160 | 280 | 280 | Mpa |
热导率 | 2 | 3 | 3.2 | W/mK |
热膨胀系数 | 7.2 | 6.1 | 6.5 | ppm/℃ |
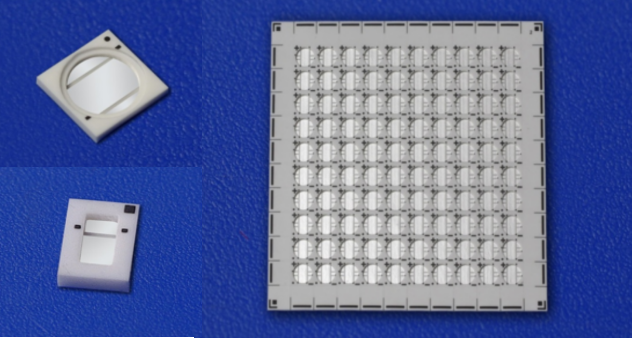
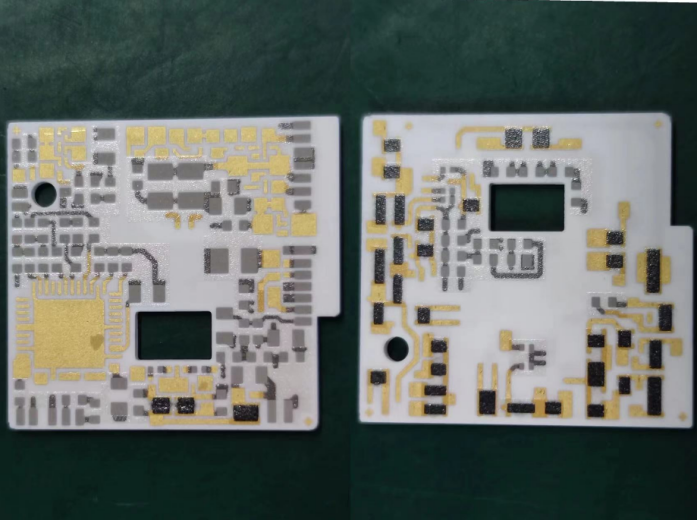
服务热线
使用微信扫描联系我们
